 AI晶片
,
ABF
,
PCB
,
CoWoS
AI晶片
,
ABF
,
PCB
,
CoWoS
市場盛傳,下一代AI晶片將挑戰現有封裝架構。CoWoS雖穩坐主流,但新技術CoWoP已引發關注,若成功量產,不僅可能改寫晶片封裝規則,更將牽動ABF與PCB供應鏈的版圖重整。
AI訓練與推論所需的高效能晶片,推升了對先進封裝技術的需求。當前市場主流架構為台積電所開發的CoWoS(Chip on Wafer on Substrate),目前被廣泛應用於科技巨頭的AI晶片產品,如輝達(Nvidia)的Blackwell GPU、亞馬遜(Amazon)的Trainium、Google的TPU、Meta的MTIA及多款車用晶片。
CoWoS自上而下由4層組成:晶片層(如GPU與HBM)、中介層、ABF載板與最底層的PCB。
與之相比,CoWoP(Chip on Wafer on PCB)則移除ABF載板,改由中介層直接連接PCB,以減少晶片厚度、降低訊號延遲與雜訊,同時提升散熱效率與NVLink傳輸表現。此技術若能順利商用,將對ABF與PCB產業供應鏈產生深遠影響。
CoWoS之所以存在4層架構,其中關鍵原因在於晶片與訊號之間的線寬/線距極小,需藉由ABF載板作為中介轉接。
現階段ABF的線寬/線距大約為10/10μm(微米),而一般PCB若要取代ABF載板,至少需達10~30μm左右,尚無法直接承接此任務。唯有將HDI(High Density Interconnect,高密度互連技術)製程升級至mSAP(Modified Semi-Additive Process,改良型半加成法)製程,才有機會達成這項技術門檻。
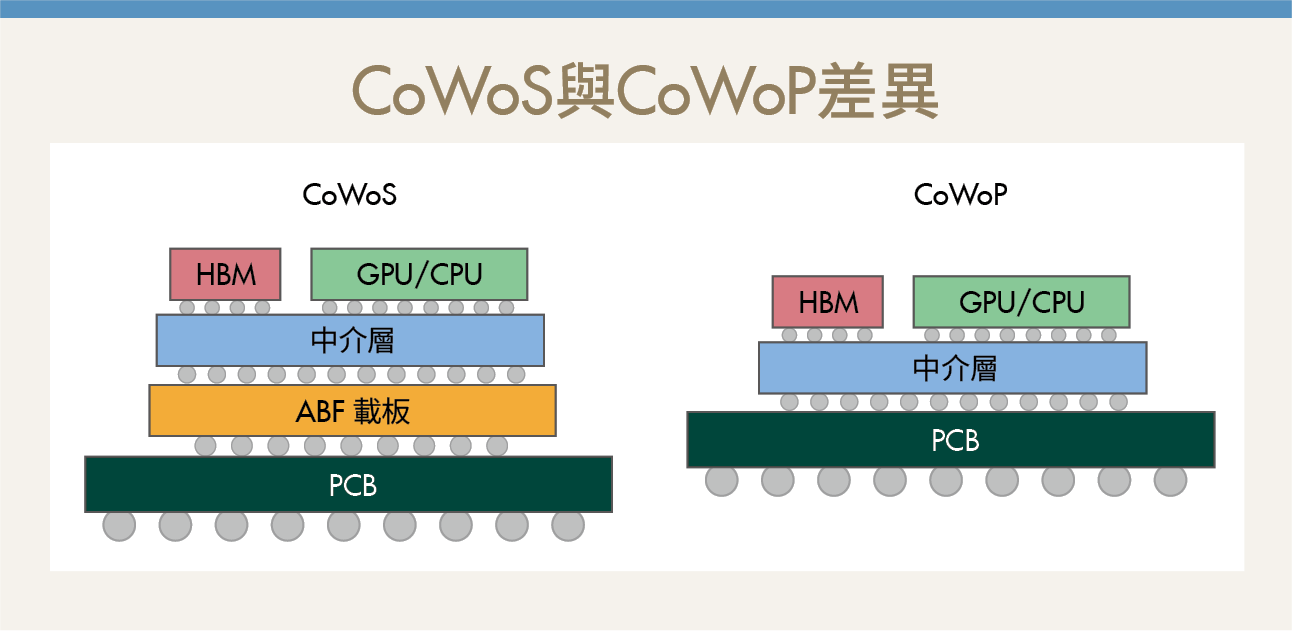
CoWoP面臨3大關鍵瓶頸 短期內CoWoS仍為主流
然而,目前採用mSAP製程的產品主要集中於Apple手機主板與1.6T光通訊模組等小尺寸產品,尚未有任何大尺寸mSAP製程產品進入量產階段。即使未來能達成量產,良率問題仍將是一大考驗。
此外,CoWoS封裝技術具有可重工的優勢,若封裝不良,仍可重新作業;但CoWoP架構一旦封裝失敗,整塊晶片與PCB都將報廢,風險顯著較高,導致良率要求更加嚴苛。這些挑戰皆使得CoWoP技術短期內難以取代CoWoS。
綜合上述技術挑戰與良率風險,市場普遍預期,輝達2027年下半年將推出的次世代GPU Rubin Ultra將不會採用CoWoP製程,仍將延續CoWoS架構。
儘管CoWoP相較CoWoS在封裝厚度、訊號傳輸與散熱方面都具備明顯優勢,但其量產前提仰賴mSAP製程成熟、良率穩定,尚需時間克服瓶頸。預估最快可能於2027年進入試產階段,若研發順利,約莫2028至2029年可望量產導入。現階段,對ABF載板需求的實質替代效應仍非常有限,封裝市場短期內仍將會以CoWoS為主流。
擁mSAP製程能力 3大PCB廠有望受惠
現階段具備mSAP製程能力的PCB廠商多集中於Apple供應鏈,包括華通(2313)、欣興(3037)、臻鼎-KY(4958)、勝宏科技、AT&S、TTM等。
其中,華通近期因低軌衛星(LEO)建設進入穩定發射階段,衛星板營收持續成長,兩大衛星客戶持續拉貨,預期2025年下半年衛星業務將維持高動能。隨著iPhone進入傳統旺季,華通作為主要供應商之一,iPhone營收預計將與2024年持平。
此外,欣興已打入輝達GB系列AI伺服器Compute Board供應鏈,採用HDI製程,GB300將於2025年第4季放量出貨。該公司光復新廠將於2025年下半年陸續投產,未來有望量產大尺寸ABF載板,並已逐步送樣AI Server應用,將成為潛在成長動能來源。
臻鼎-KY則為iPhone軟板主要供應商,2025年整體iPhone銷量預估與2024年持平,因此手機業務將呈穩定態勢。PC/NB業務則已於2025年第2季提前出貨,預期下半年表現將與上半年持平。
儘管AI ASIC UBB供應鏈貢獻尚低,但臻鼎已成功從高階軟板跨入高階PCB板領域。泰國廠一期將於2025年下半年量產,可望進一步擴大ABF/BT載板供應能力。
(圖片來源:Shutterstock僅示意/ 內容僅供參考,投資請謹慎為上)
文章出處:《Money錢》2025年9月號
下載「錢雜誌App」隨時隨地掌握財經脈動
理財工具推薦













